 |
| |
|
|
 |
| |
 |
較傳統封裝有成本效益 |
 |
最佳的電氣特性 |
 |
最小、最薄、最高密度的封裝方式 |
 |
高產能及最短的生產時間 |
 |
重新佈線層最小線寬線距可達20/20um |
 |
錫球凸點最小可達間距250um |
|
|
|
| |
|
|
 |
| |
 |
使用傳統的SMT 技術即可完成高密度的堆疊 |
|
|
支援廣泛的產品應用(光感測器, 影像感測器, 多芯片模組) |
|
|
MCP, SiP, 多芯片模組, CMOS 圖像感測器, 光感測器, LED, 邏輯IC, MEMS, 射頻芯片, 基帶IC….雙面的重新佈線, 由矽穿孔技術及3D 堆疊技術可做出 |
| |
|
|
|
|
| |
付費晶片貼卡代工 |
|
 |
| |
 |
晶圓級封裝成就最薄, 最低成本的代工方式 |
|
|
最小尺寸封裝,可放入最新/最小規格的SIM 卡 |
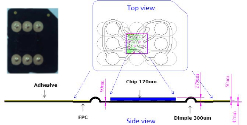 |
|
|
|
 |
